판매용 중고 VON ARDENNE WM70H / C #9172921
URL이 복사되었습니다!
확대하려면 누르십시오




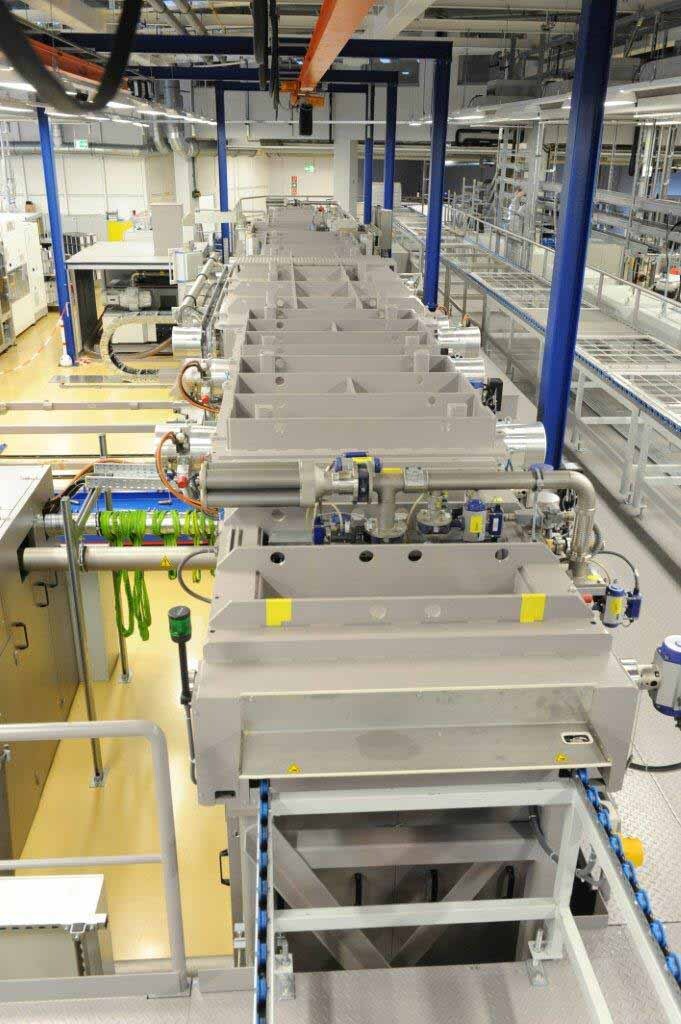



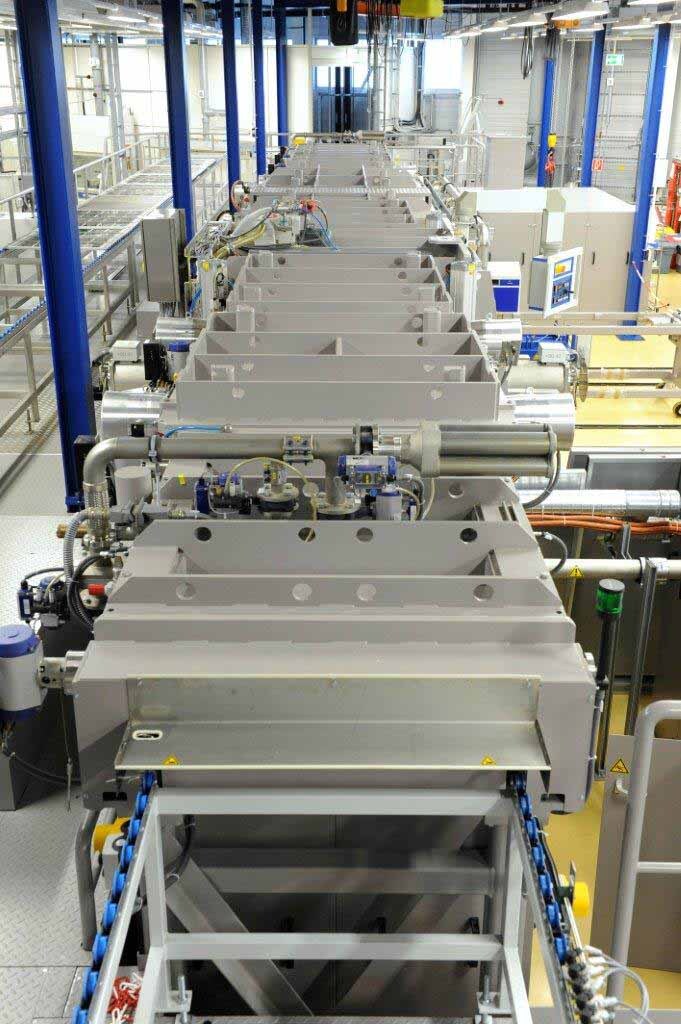



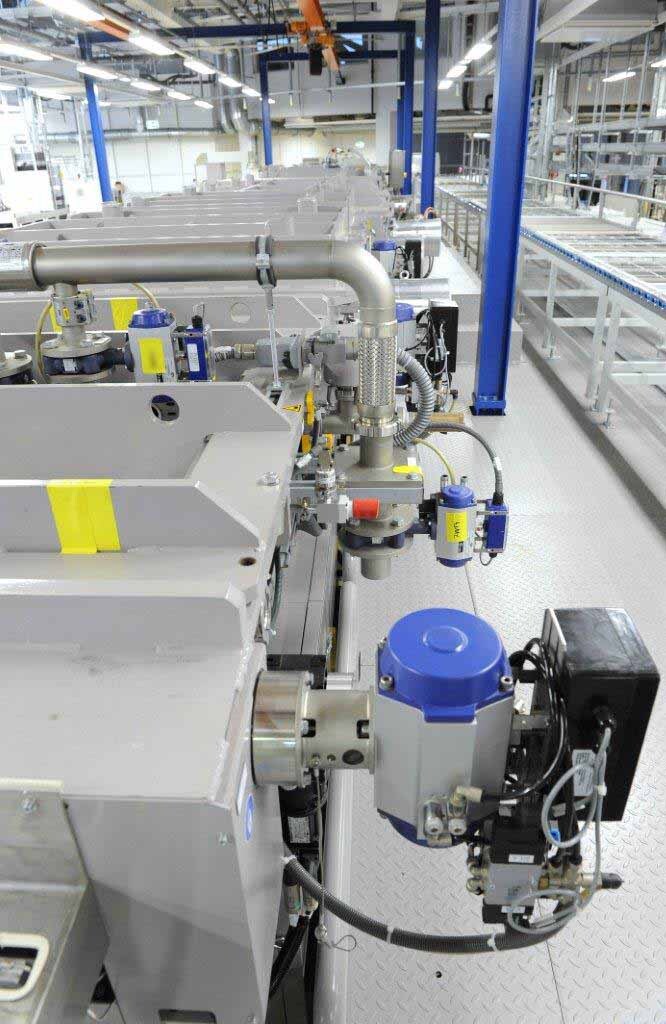

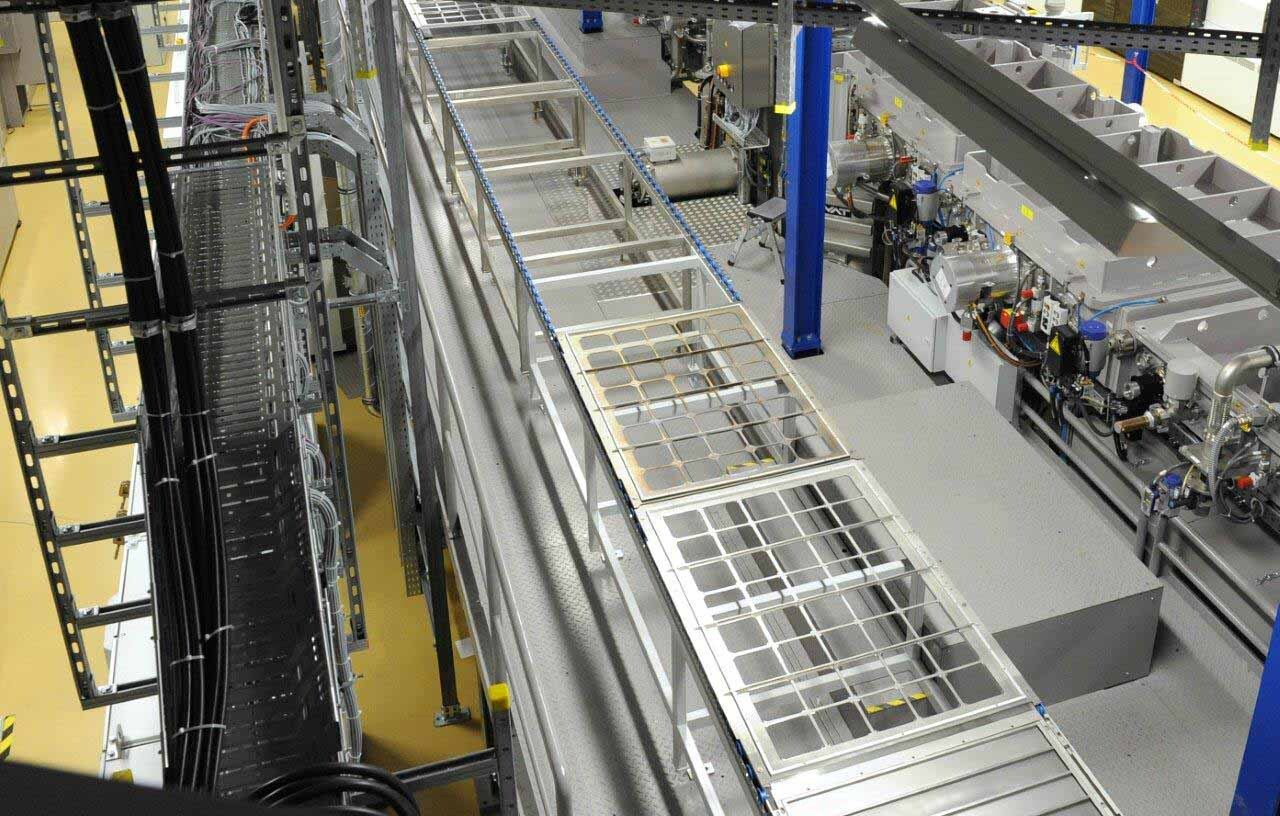



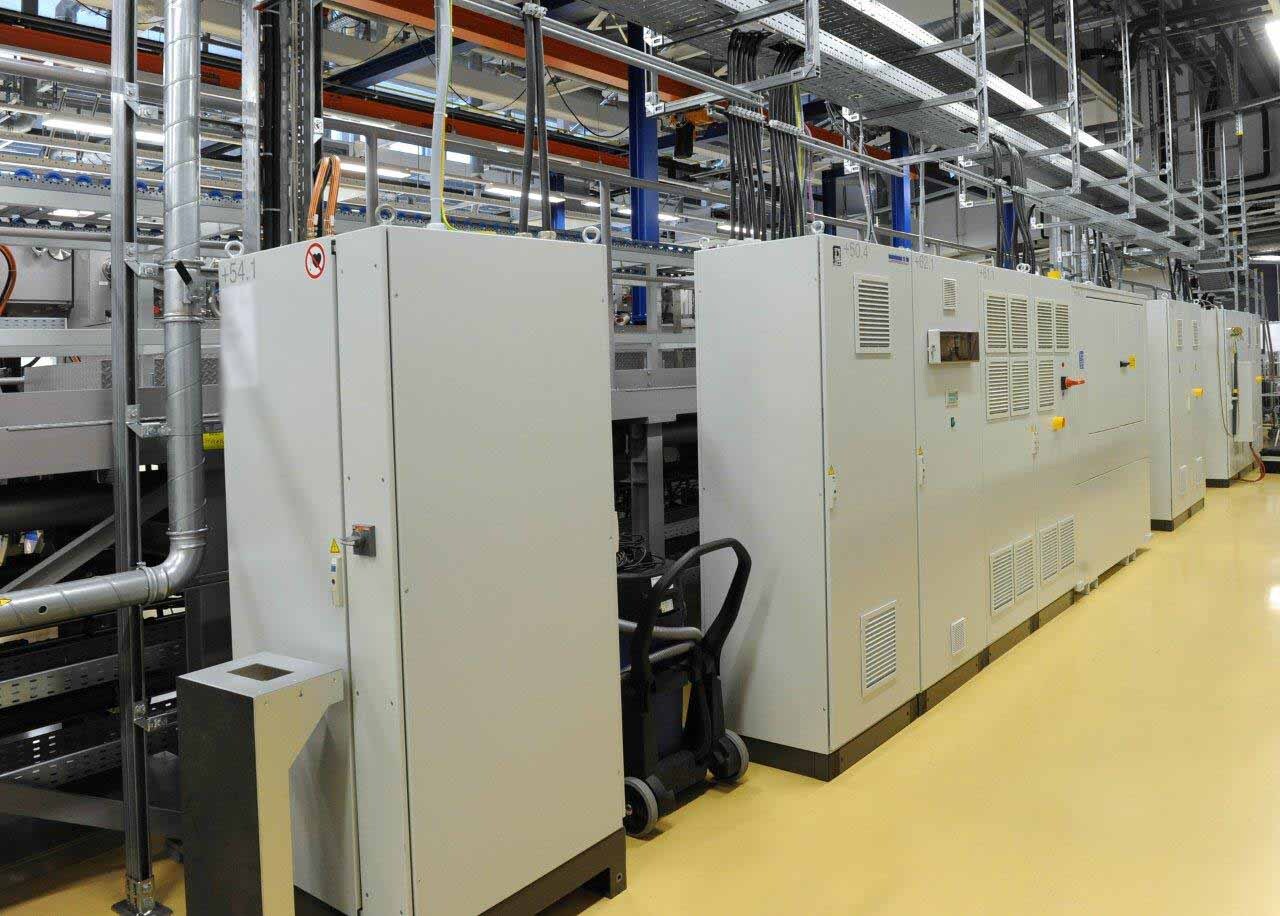







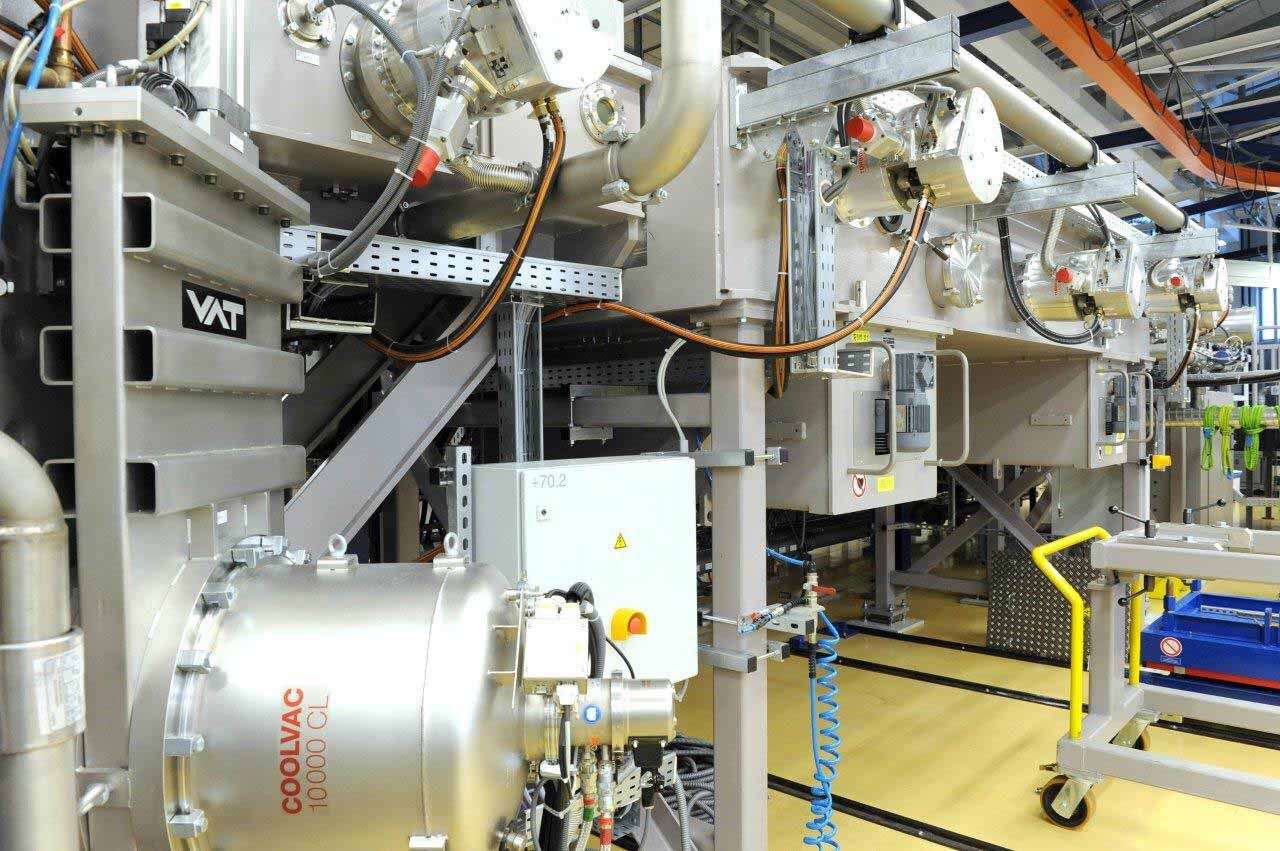





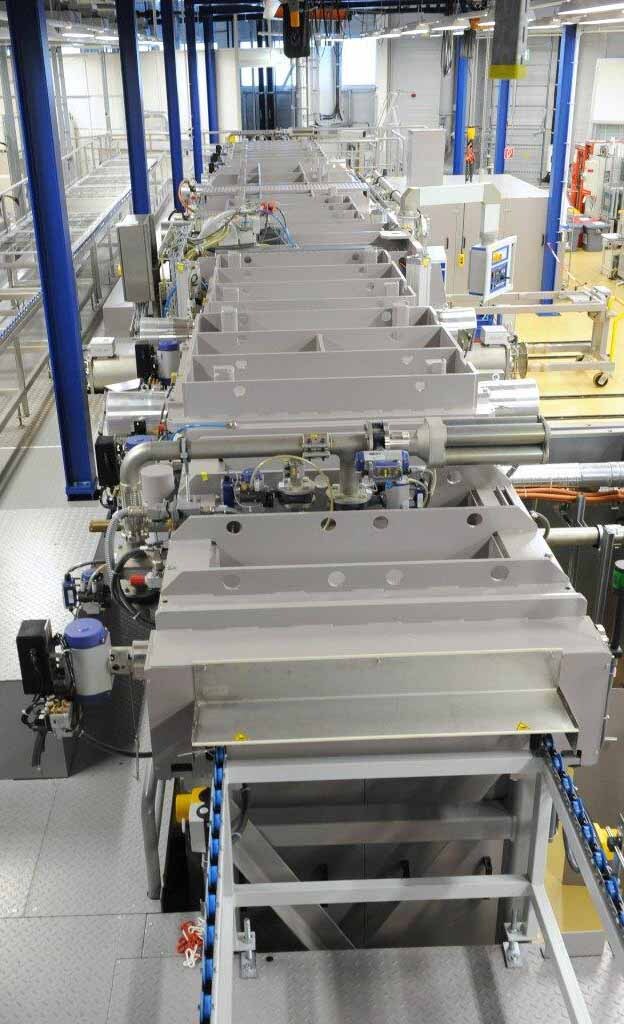













ID: 9172921
High end coating line
Wafer metallizer
In-line complete system for coating wafers
Back coating of silicon wafers with an aluminum layer
Coating of nickel, silver and aluminum by electron beam evaporation
(35) Cells can be coated per tray
Productivity:
4,000 Wafers (5") per hour
2,600 Wafers (6") per hour
Cycle time: 50s
Technical parameters:
System dimensions:
Length: 19 m
Area: 20 x 7 m
Height: ~3 m
Drive:
Carrier speed max: 5 m/min
Carrier speed during vapor deposition: 1.5 - 2.0 m/min
Substrate temperature:
Max. temperature: 300°C / 572°F
Carrier dimensions:
Length: ~1,450 mm
Width: 925 mm
(60) Wafers (5") per carrier
(40) Wafers (6") per carrier
Ambient conditions:
Ambient temperature:
+15 to 35 °C
+59 to 95 °F
Relative humidity at 30°C / 86°F: < 70 %
Dust: < 10 mg/m3
Sluice chambers C1 and C7
Buffer chambers C2 and C6
Transfer chamber C5
Process chamber C4:
EB Chamber C3 / C4.1 / C4.2
Sputter chambers
(5) Sections (C4.3 to C4.7)
Vacuum
Working pressure:
C2 - Buffer chamber 2 to 5 x 10-3 mbar
C4.1 - EB chamber 5 to 9 x 10-5 mbar
C4.2 - Intermediate chamber 2 to 5 x 10-4 mbar
C4.3 - Intermediate chamber 2 to 5 x 10-3 mbar
C4.4 - Sputter chamber 2 to 5 x 10-3 mbar
C4.5 - Pump chamber 2 to 5 x 10-3 mbar
C4.6 - Sputter chamber 2 to 5 x 10-3 mbar
C4.7 - Intermediate chamber 2 to 5 x 10-3 mbar
C5 - Transfer chamber 2 to 5 x 10-3 mbar
C6 - Buffer chamber 2 to 5 x 10-3 mbar
Leak rate: < 1 x 10-2 mbar l/s-1
Layer thickness / Properties:
AI with copper:
Thickness: 2 μm
Wafer thickness: > 200 μm
Temperature: 400°C / 752°F
Purity: 99.98%
AI with ceramic:
Thickness: 3 μm
Wafer thickness: 150 to 250 μm
Temperature: 300°C / 572°F
Purity: 99.5%
Ag: Thickness: < 300 nm
Sn: Thickness: < 300 nm
NiCr: Thickness: < 40 nm
Uniformity: ± 10%
Evaporation:
Production cycle: 120 h
Power of electron beam
Copper crucible: 100 to 200 kW
Ceramic crucible: 20 kW
Target material per cycle: 90 to 150 kg
Vapor utilization: 48 to 50 %
Target-substrate distance: 600 mm
Carrier frequency: 60s
Sputtering:
Target material: Ag
Target utilization: ~70%
Target life: 240 h
Cooling water:
Particle size: ~50 mg/l
pH Value: (8.0 to 9.0)
Electrical conductivity: (150 to 250) μS/cm
Acid capacity, Ks 4.3: (0.5 to 2.0) mmol/l
Filterable substances: < 50 mg/l
Chloride: < 10 mg/l
Sulfate: < 30 mg/l
Ammonium: < 0.5 mg/l
Nitrate: < 10 mg/l
Colony count (CFU): ~ 1,000 ml-1
TOC (total organic carbon): < 1.5 mg/l
Inlet temperature:
21 to 25°C
69.8 to 77°F
Differential pressure: 2 bar
Absolute pressure max: 8 bar
Water circuit 1 chambers:
Volume flow: TBD m3/h
Temperature: 25°C / 77°F
Required pressure: 6 - 8 bar
Cooling capacity: TBD kW
Electrical system:
3 Phases, 3 AC 480 V
Tolerance: -10/+6 %
Frequency: 59 to 61 Hz
Grounding resistance: <2 Ohm
Connected load max: 400 kVA
Function:
Wafers are coated on one side with (2) metal layers.
VON ARDENNE WM70H/C는 고품질의 박막 이미지와 패턴을 생산할 수있는 고급 Photoresist 장비입니다. 이 시스템은 너비 70 nm, 높이 100 nm, 정확도 2 nm까지 크기를 만들도록 설계되었습니다. 이 장치는 포토 마스크, 리소그래피 기계, 수많은 유체 성분, 가스 디스펜서 및 저항 소스와 같은 여러 구성 요소로 구성됩니다. "웨이퍼 '의 표면 을 무늬 하는 데 사용 되는" 포토마스크' 는 먼저 석판기 에 실린다. 그 다음, 유체 성분 들 은 "레지스트 '(화학 혼합물) 를 광장" 마스크' 와 "웨이퍼 '에 급속히 분배 시키고 그것 을 균일 하게 퍼뜨리는 데 도움 이 된다. 그런 다음, "레지스트 '는 홍수 의 근원 으로부터 나오는 빛 에 노출 되어, 표면 의 세부점 들 이 형성 될" 템플릿' 역할 을 하는 저항 "패턴 '을 만든다. "가스 '분배기 는" 가스' 의 흐름 을 처리 하고 유화액 의 일관성 을 보충 하기 위하여 저항 표면 위 에 보호 불소 "필름 '을 정확 하게 적용 시킨다. 그런 다음 "레지스트 '는 벗겨지고, 으깨고, 말리고," 웨이퍼' 는 더 많은 "에칭 '과정 을 거치고, 저항군 은 벗겨질 준비 가 되어 있다. WM70H/C 기계는 시장에서 가장 최첨단 구성 요소를 특징으로하며 70 ~ 100 nm 사이의 반도체 리소그래피 프로세스에 대한 뛰어난 이미지 배치 정확도, 정밀 패턴 정의 및 고화질 필름 구조를 제공합니다. 에치 후 고조파 이미징 도구와 함께 사용할 때, WM70H/C는 명확하고 상세한 기능을 제공하며, 정확도는 2nm입니다. 또한, 광범위한 매개변수 (parameter) 와 자동 작업 (automated operation) 을 통해 최소한의 설정 시간이 보장되므로 생산성이 크게 향상됩니다. 고급 반도체 프로세스의 대용량 생산 환경에 이상적입니다.
아직 리뷰가 없습니다