판매용 중고 JEOL JEM 2010F #293595837
URL이 복사되었습니다!
확대하려면 누르십시오


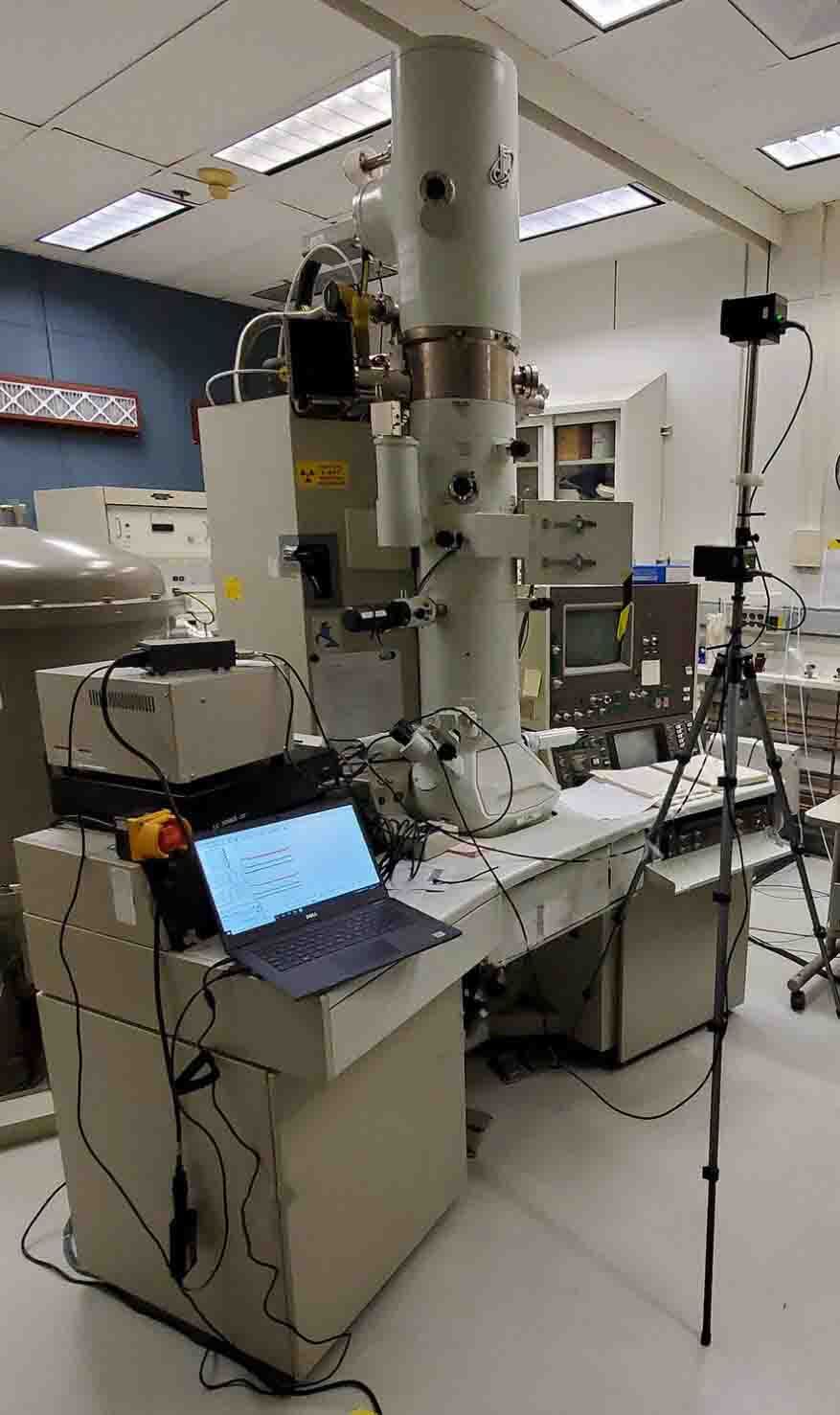

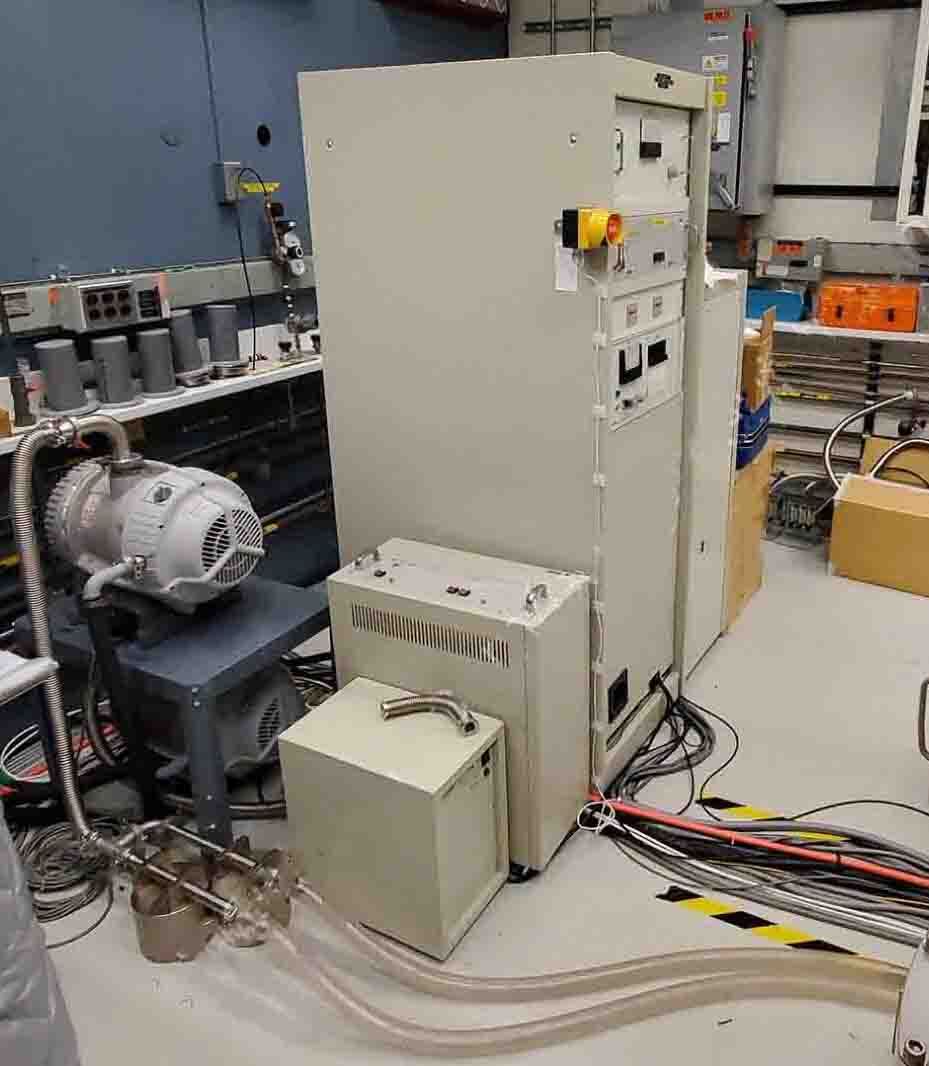





ID: 293595837
빈티지: 2000
Transmission Electron Microscope (TEM)
Ultra High Resolution (UHR) / High Resolution (HR) / High specimen Tilt (HT) / Cryo Polepice (CR) / High Contrast (HC)
Polepice: URP / HRP / HTP / CRP / HCP
Point: 0.19 nm / 0.23 nm / 0.25 nm / 0.27 nm / 0.31 nm
Lattice: 0.1 nm / 0.1 nm / 0.1 nm / 0.14 nm / 0.14 nm
Focal length: 1.9 mm / 2.3 mm / 2.7 mm / 2.8 mm / 3.9 mm
Spherical coefficient: 0.5 mm / 1.0 mm / 1.4 mm / 2.0 mm / 3.3 mm
Chromatic coefficient: 1.1 mm / 1.4 mm / 1.8 mm / 2.1 mm / 3.0 mm
Focal step: 1.0 nm / 1.4 nm / 1.8 nm / 2.0 nm / 5.2 nm
Solid angle (30 mm²): 0.13 sr / 0.13 sr / 0.13 sr / - / 0.09 sr
Solid angle (50 mm²): 0.24 sr / 0.28 sr / 0.23 sr / - / 0.09 sr
Take-off angle (30 mm²): 25° / 25° / 25° / - / 20°
Take-off angle (50 mm²): 22.3° / 24.1° / 25° / - / 20°
MAG mode: x2,000 to 1,500,000 x 1,500 to 1,200,000 x1,200 to 1,000,000 x1,000 to 800,000
Low MAG: x50 to 6,000 x 50 to 2,000
SA MAG: x8,000 to 800,000 x6,000 to 600,000 x 5,000 to 600,000 x 5,000 to 400,000
SA diffraction: 80 to 2,000 mm, 100 to 2,500 mm, 150 to 3,000 mm
HD: 4 to 80 m
HR: 333 mm
Minimum step size: 50 V
Specimen tilting holder
High tilt specimen retainer
STEM5 Bright-field lattice: 0.2 nm
Electron source:
Schottky emitter: ZrO / W(100)
Brightness: ≧4x10^-8 A / cm² / sr
Pressure: 1x10^-8 Pa
Probe: 0.5 nA for 1 nm
Power Stability:
AC Voltage: ≦1x10^-6 / min
OL Current: ≦1x 10^-6 / min
Modes:
TEM: 2 to 5 nm, 7 to 30 nm
EDS: 4 to 20 nm
NBD: 0.5 to 2.4 nm
CBD: 1.0 to 2.4 nm
Parameters:
Convergence angle: 1.5 to 20 mrad
Acceptance angle: ±10°
Specimen shift:
X, Y-Axis: 2 mm, 2 mm, 2 mm, 2 mm, 2 mm
Z-Axis: ±0.1 mm, ±0.2 mm, ±0.2 mm
Specimen tilt:
X / Y-Axis: ±25 / ±25°, ±35 / ±30°, ±42 / ±30°, ±15 / ±10°, ±38 / ±30°
X-Axis: ±25°, ±80°, ±80°, ±80°, ±80°
Power supply: 160 kV, 200 kV
2000 vintage.
JEOL JEM 2010F는 분석 및 재료 과학 응용을 위해 설계된 주사 전자 현미경 (SEM) 입니다. 냉음극 (전계 방출) 전자원이 장착되어 있으며, 소스 안정성과 밝기가 뛰어납니다. 소스는 민감한 샘플을 조사하기위한 저전압 모드 (low voltage mode) 와 함께 고해상도, 소형 직경 전자 빔을 생성합니다. 저에너지 이미징 (Low Energy Imaging) 단계에서는 샘플의 충전 없이 높은 배율 이미지를 얻을 수 있습니다. 열 내 구성에는 에너지 필터링 이미징 옵션, 동축 EDX 검출기 및 전용 Schottky 총이 포함됩니다. 이 장비에는 또한 높은 확대 및 대비 이미징을 제공하는 텅스텐 필라멘트 백스캐터 전자 검출기 (tungsten filament back-scattered electron detector) 가 있습니다. JEOL JEM-2010F 주사 전자 현미경은 선형 드라이브가 장착 된 통합 된 전동 x-y 단계와 10 위치 자동 전진 샘플 홀더로 구동됩니다. 통합 된 전동 X-y 스테이지는 전자 현미경 (Electron Microscope) 의 시야 내에서 샘플을 쉽게 재배치하기위한 높은 정밀 움직임을 제공합니다. 외부 교정 제어 (calibration control) 에 따라 다음 샘플 위치를 자동으로 진행하여 고수율 이미징을 제공합니다. 마운트에는 전자 현미경 (electron microscope) 에서 직접 파일에 매개 변수 데이터를 자동으로 기록하는 소프트웨어 인터페이스도 있습니다. 또한 JEM 2010F에는 라이브 이미징 응용 프로그램을위한 디지털 X-Y 컨트롤러가 장착되어 있습니다. 디지털 X-Y 컨트롤러 (Digital X-Y Controller) 는 최신 디지털 이미징 기술을 활용하여 디지털 이미징 모듈에 직접 연결된 내장형 카메라 시스템을 지원합니다. 이 시스템은 고급 디지털 기술 (Advanced Digital Technology) 을 사용하여 높은 해상도와 빠른 주기 시간을 제공할 수 있습니다. 마지막으로, JEM-2010F는 완전하게 자동화된 기능과 수동 설정을 모두 포함하는 포괄적인 이미지 분석 패키지를 갖추고 있습니다. 모서리 감지, 입자 추적 및 모양 인식과 같은 고급 이미지 처리 알고리즘이 포함됩니다. 이 인터페이스를 통해 멀티모달 이미징 (multi-modal imaging) 과 다양한 분석 도구 (analytical tools) 를 사용할 수 있으므로 사용자가 결과를 보다 효과적으로 제어할 수 있습니다.
아직 리뷰가 없습니다




