판매용 중고 JEOL JEM 2010F #293585832
URL이 복사되었습니다!
확대하려면 누르십시오
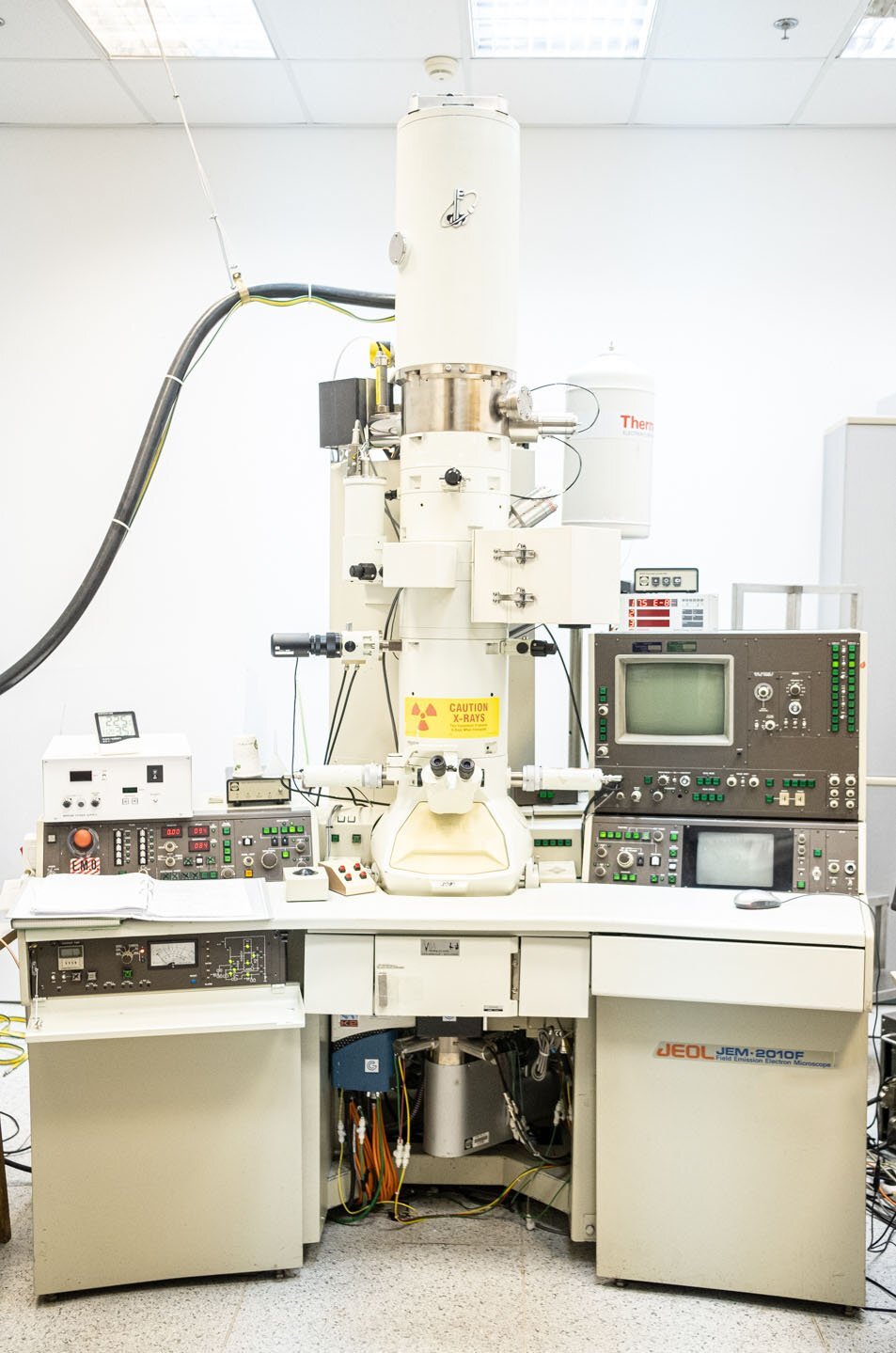





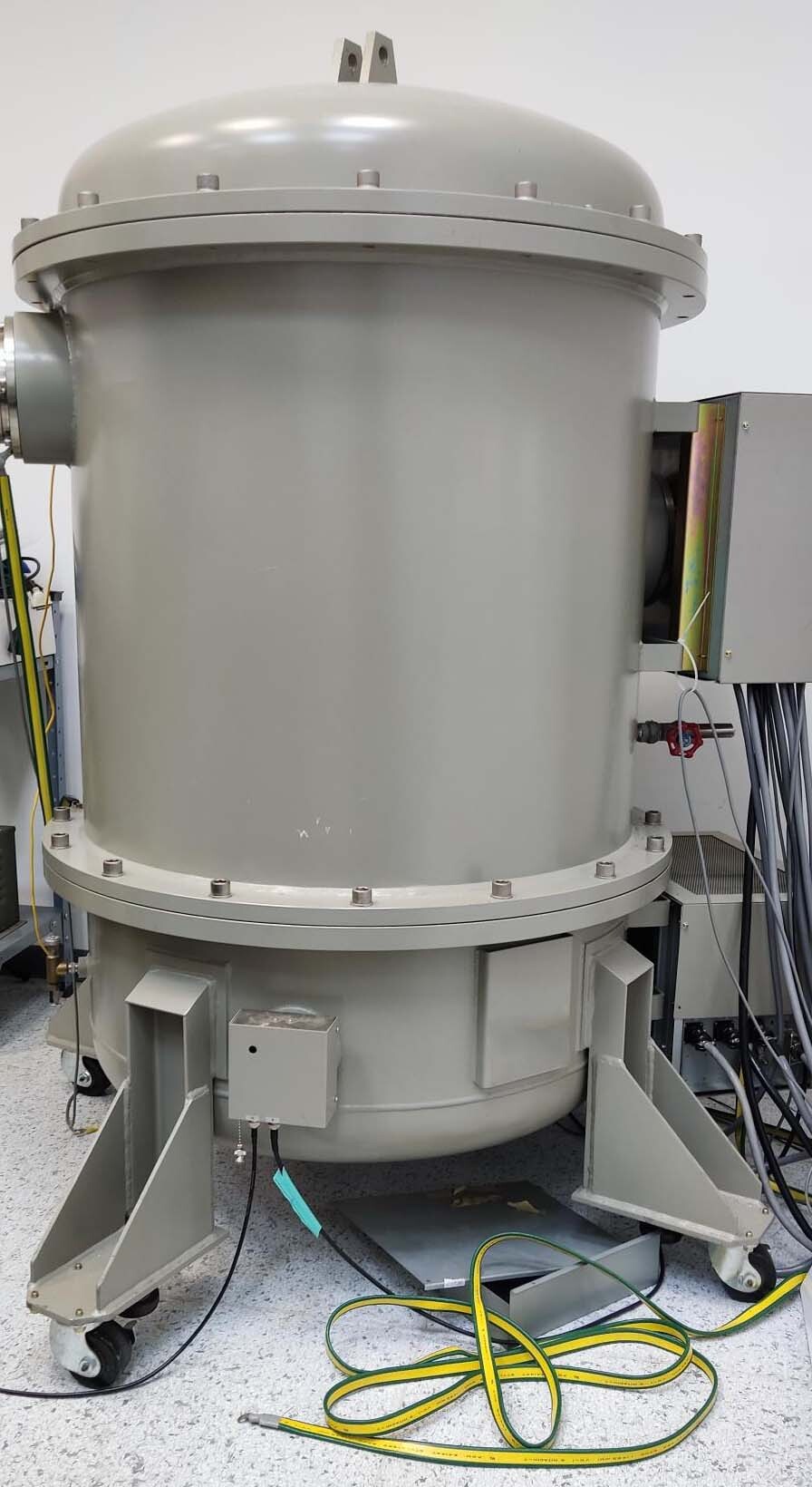









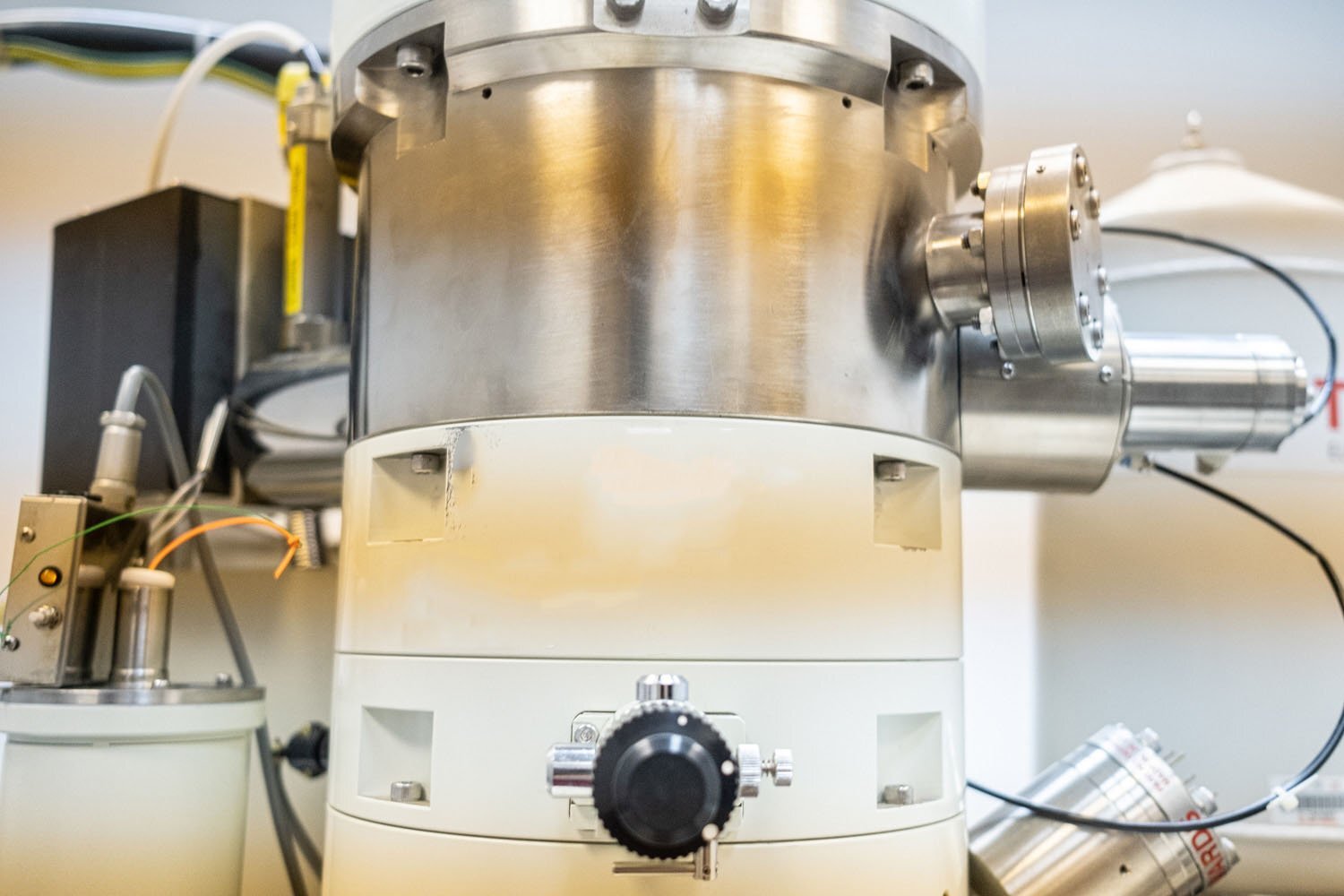































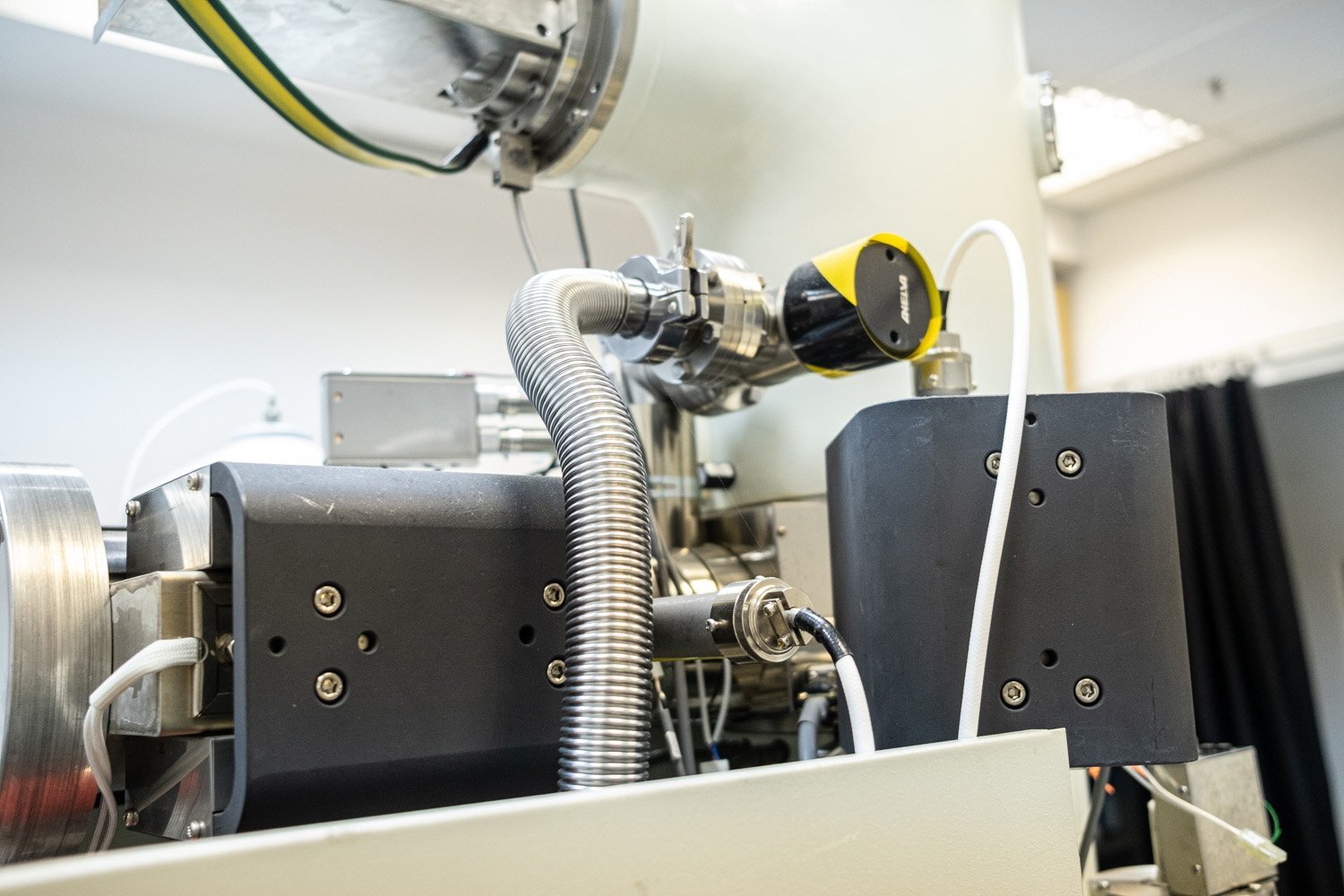





















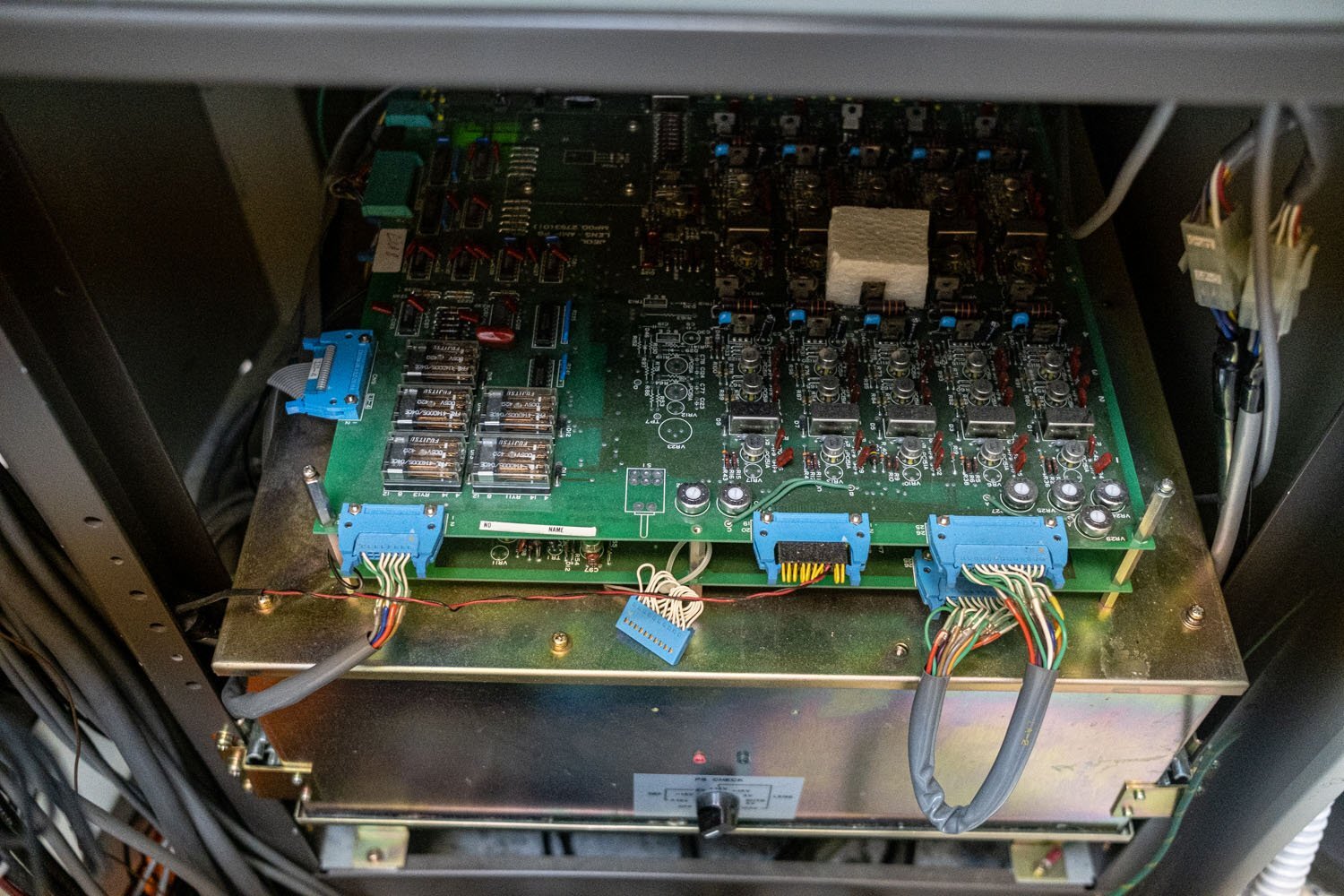

















































ID: 293585832
Scanning Transmission Electron Microscope (STEM)
UHR Objective pole
Spherical aberration coefficient: 0.5 mm
Point-point resolution: 0.19 nm
Information limit: 0.1 nm
Energy resolution: 133 eV
SiLi detector
Resolution imaging
Collection angle: 0.13 Sterad
Take off angle: 20°
Phase resolution: 100 rad
JEOL Bi-Prism electron holographic measurements
Medium and low magnifications
EDS
EELS
K2
Power supply: 80 kV-200 kV.
JEOL JEM 2010F는 연구원, 기술자 및 업계 전문가에게 하위 미크론, 기능 수준 분석에 필요한 도구를 제공하는 고급 스캔 전자 현미경 (SEM) 입니다. JEOL JEM-2010F는 다양한 재료 분석, 미크론 수준 관찰, 결함 분석 및 자동 작동에 최적화되었습니다. JEM 2010F는 건조 및 액체 형태의 재료를 포함하여 작은 샘플의 매우 높은 해상도 이미지를 제공합니다. 1 미크론 조리개에서 200 미크론 범위까지 다양한 샘플 크기를 분석 할 수 있습니다. JEM-2010F 가 제공하는 대용량 필드 (field of field) 를 사용하면 최대 150,000X 의 높은 배율로 세부 이미지를 캡처할 수 있습니다. 고해상도 (high resolution) 와 심도 (depth of field) 의 조합은 포함, 부식, 곡물 경계 및 결정 결함과 같은 표면 및 지하 고대비 기능을 감지 할 수 있습니다. 또한 JEOL JEM 2010F는 고급 소프트웨어 기술로 가능한 다양한 자동 현미경 기능을 제공합니다. JOL JEM-2010F (JEOL JEM-2010F) 의 자동화된 기능은 분석 (analysis) 의 여러 단계에서 가져온 이미지 수집, 여러 샘플을 동시에 작업, 스캐닝 프로세스를 제어하는 다양한 도구 사용 등 다양한 유용한 옵션을 제공합니다. 또한 JEM 2010F (Advanced Signal Analysis) 옵션에는 다양한 샘플 및 분석 유형에 대한 여러 가지 고급 신호 분석 옵션이 포함되어 있습니다. JEM-2010F에서 사용할 수있는 신호 분석 도구 (signal analysis tools) 는 신호 패턴, 반음계 변경 및 열지도를 분석하여 소규모로 미세 구조의 변화를 감지하는 데 사용할 수 있습니다. JEOL JEM 2010F의 성능은 지능형 제어 장비 (ICS) 에 의해 더욱 향상되었습니다. 정보통신기술 (ICS) 은 인공지능 (Intelligence) 을 통합해 운영할 때마다 시스템이 제대로 작동하고 영상이 최적화되도록 한다. 지능형 장치 (Intelligent Unit) 를 사용하면 완전히 자동화된 측정 시나리오를 통해 이미지 처리 속도 향상, 처리량 향상, 일관된 결과를 얻을 수 있습니다. 결론적으로, JEOL JEM-2010F는 다양한 기능을 갖춘 고급 SEM으로, 상세한 수준의 실시간 이미지를 제공합니다. 자동 이미징 (Automated Imaging) 및 신호 분석 (Signal Analysis) 기능은 고품질의 결과를 보장하는 다양한 강력한 도구를 제공하며, 지능형 제어 (Intelligent Control) 시스템은 모든 이미지에서 안정성과 정밀도를 제공합니다.
아직 리뷰가 없습니다