판매용 중고 OXFORD Plasmalab 100 #9410020
URL이 복사되었습니다!
확대하려면 누르십시오


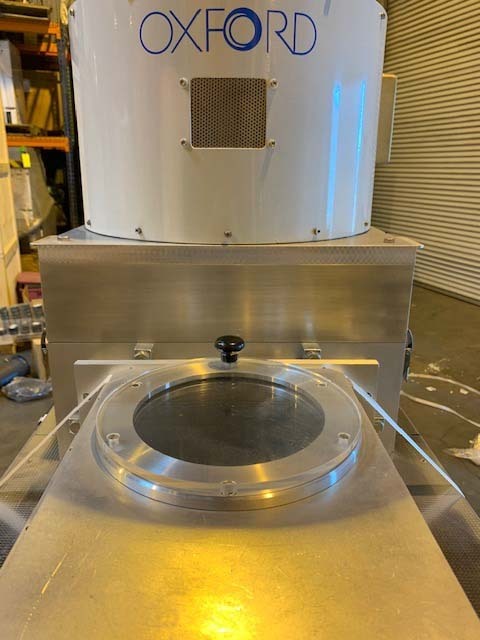









ID: 9410020
웨이퍼 크기: 3"-8"
빈티지: 2000
ICP Reactive Ion Etcher (RIE), 3"-8"
Chamber
Low temperature silicon etching system
Unique process gases:
Hexafluoroethane (C2F6)
Octafluorocyclobutane (C4F8)
Trifluoromethane (CHF3)
Hydrogen
Anisotropic etching system:
Silicon
Silicon oxide
Silicon nitride
Electrode temperature range: -150 °C to 300 °C
Power source: Up to 600 W at 13.56 MHz
Radio Frequency (RF) Power source: Up to 600 W at 13.56 MHz
2000 vintage.
옥스포드 플라즈말랩 100 (OXFORD Plasmalab 100) 은 정밀도 및 표면 에칭뿐만 아니라 정확한 샘플 준비를 위해 설계된 최첨단 에처 및 애셔 시스템입니다. 고급 플라즈마 표면 수정 및 나노 스케일 처리에 이상적입니다. 이 장치는 높은 온도, 높은 화면 비율, 낮은 저항성 및 높은 전력 식각 프로세스에서 뛰어난 성능을 제공합니다. Plasmalab 100은 두 가지 구성 요소, 즉 플라즈마 프로세서와 챔버로 구성됩니다. 플라즈마 프로세서는 전원 공급 장치, 가스 분배 시스템, 에칭 챔버 및 모니터링을위한 2 개의 뷰 포트로 구성됩니다. 전원 공급 장치는 에칭 챔버 (etching chamber) 에 최대 55kW의 전력을 출력하며, 디지털 온도 조절 (digital temperature control) 과 가스 흐름 및 압력 직접 제어 (direct control of gas flow and pressure) 를 통해 프로세스를 정확하게 조정하고 유지 관리할 수 있습니다. 챔버에는 480mm x 480mm 정전기 척이 장착되어 있으며 조정 가능한 편견이 있습니다. "척 '의 얼굴 은 필요 할 때 다른 각도 로 조정 될 수 도 있다. 정밀도 선형 액추에이터를 사용하여 고밀도 높이 및 각도 조정이 가능합니다. 가스 분포 시스템은 최대 4 개의 독립 밸브와 4 개의 별개의 가스 공급 라인으로 구성되며, 이는 챔버 내에서 압력과 조성을 정확하게 제어합니다. "밸브 '는 자동화 되므로 공정 조건 을 변화 시키도록 정확 하게 제어 할 수 있다. 에칭 챔버 (etching chamber) 는 스테인리스 스틸 (stainless steel) 과 수동화 된 실리콘 산화물 (silicon oxide) 으로 만들어졌으며, 이는 낮은 접착면뿐만 아니라 높은 수준의 청결성을 유지하는 데 이상적입니다. 챔버 (chamber) 는 온도 조절이며, 방사선에서 사용자를 보호하기위한 주로 내부 아키텍처를 가지고 있습니다. 또한 압력을 제어하기위한 압력 제어 밸브가 장착되어 있습니다. 옥스포드 플라즈말랩 100 (OXFORD Plasmalab 100) 은 다양한 재료의 고정밀 에칭 및 표면 수정을 위해 설계되었습니다. 특히 마이크로 기어, 나노 와이어 (nanodevice) 및 MEMS (MEMS) 와 같은 복잡한 장치뿐만 아니라 작은 부품의 나노 정리에 적합합니다. 또한 photoresist etching, RIE/ICP etching 및 기타 형태의 처리에 사용할 수 있습니다. 이 시스템은 매우 유연하고 구성 가능하며, 다양한 가스 유형, 고정 (fixturing) 및 자동화 옵션을 제공합니다. 설치, 운영 및 유지 관리가 쉽습니다.
아직 리뷰가 없습니다