판매용 중고 ESEC 3088iP #9091724
URL이 복사되었습니다!
확대하려면 누르십시오
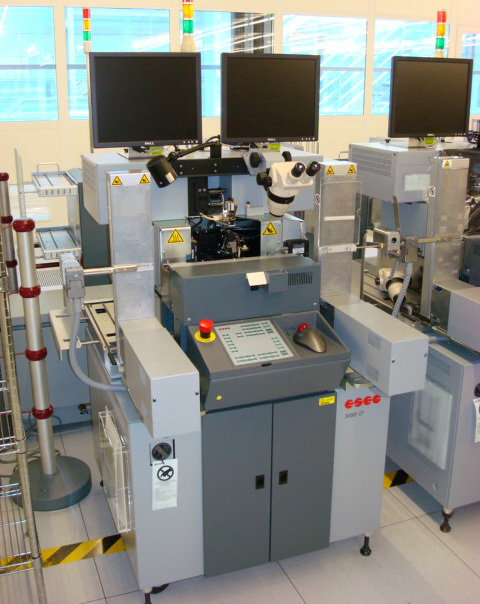

ID: 9091724
빈티지: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Max. bonding area: 52 x 64mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227mm / 8.93"
Width (adjustable): 120mm / 4.72" to 260mm / 10.23"
2002 vintage.
ESEC 3088iP 는 ESEC Corporation 의 지능형 고성능 다이 본더입니다. 제조업체가 정밀도, 속도, 정확도로 가장 높은 수율을 얻을 수 있도록 설계되었습니다. 다이 본딩 (die bonding) 작업을 이전보다 쉽고 빠르게 수행할 수 있도록 특별히 설계되었습니다. ESEC 3088I P 는 최첨단 비전 장비로, 운영자가 최대한의 정밀도로 교체 다이를 정확하게 파악하고 정렬할 수 있게 해 줍니다. 또한 프로세스 (process) 를 실시간으로 모니터링하고 조정하여 최고 수준의 정확도와 성능을 보장하는 통합형 마이크로컨트롤러 (microcontroller) 를 제공합니다. 3088 IP는 SIP, ALUMINUM, CSP, DIP, DIE 플레이트 등을 포함한 다양한 패키지 유형과 크기를 처리 할 수 있습니다. 3088I P는 최적의 성능을 위해 다이 본딩 (die bonding) 프로세스를 관리하고 조정하는 데 도움이 되는 정교한 마이크로프로세서로 구동됩니다. 고급 스테인레스 스틸 (Stainless Steel) 과 재료로 제작되어 까다로운 생산 환경을 견딜 수 있습니다. 또한 내장 롤러 (roller) 및 프레스 시스템 (press system) 을 통해 정확하고 반복 가능한 동작을 통해 사망을 정확하게 배치하고 장착할 수 있습니다. 3088iP에는 다양한 본더 삽입 스타일 및 구성을 수용 할 수있는 다이 첨부 시스템 (Die Attach System) 이 있습니다. 납납 및 접착 결합 프로세스를 모두 지원합니다. 더 얇고, 더 평평하고, 더 반복 가능한 다양한 다이 본드를 만들 수 있습니다. 또한 표준 (standard) 및 하이퍼 줌 (hyper-zoom) 비전 시스템을 선택할 수 있는 내장 비전 유닛이 내장되어 있어 운영자가 뛰어난 정확도로 다이를 식별하고 찾을 수 있습니다. 또한, ESEC 3088 IP에는 결합 전에 재료 입자를 제거하는 통합 웨이퍼 클리너 (wafer cleaner) 와 연산자가 최적의 결과를 위해 다이 배치를 정확하게 조정할 수있는 상단 장착 다이 조정 머신이 있습니다. 또한 자동 상태 모니터 (Automated Status Monitor) 및 경고 도구 (Warning Tool) 를 사용하여 시정 조치를 취해야 할 때 적절한 알림을 제공합니다. 결론적으로 ESEC 3088iP 는 최첨단 비전 시스템과 마이크로프로세서 제어 프로세스를 갖춘 지능형 고성능 본더입니다. 다이 본드 (die bonds) 를 생성하고 정확하고 반복 가능한 동작을 제공 할 수 있습니다. 다이 본더 (Die Bonder) 에서 최고의 성능과 신뢰성을 원하는 제조업체에게는 이상적인 선택입니다.
아직 리뷰가 없습니다