판매용 중고 ESEC 3088iP #9091720
URL이 복사되었습니다!
확대하려면 누르십시오
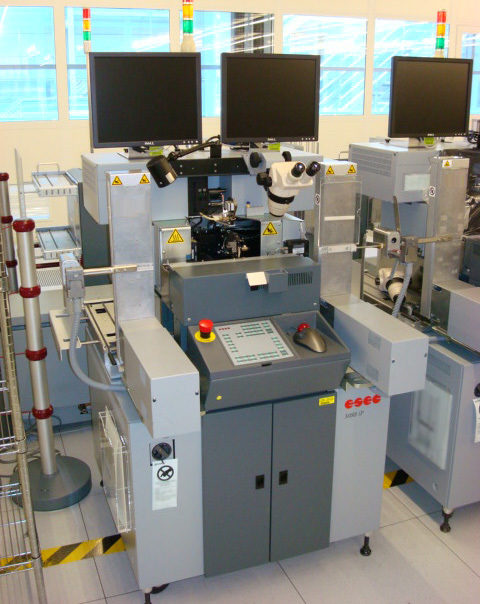

ID: 9091720
빈티지: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Max. bonding area: 52 x 64mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227mm / 8.93"
Width (adjustable): 120mm / 4.72" to 260mm / 10.23"
2002 vintage.
ESEC 3088iP (ESEC 3088iP) 는 반도체 칩과 리드의 개별 핀 사이에 단단한 전기 연결을 형성하도록 설계된 산업용 반도체 패키징 머신입니다. 이 기계는 고급 웨지 (Wedge) 및 바 (Bar) 본더 기술을 사용하여 정밀 반도체 패키지의 처리량을 높입니다. ESEC 3088I P 패키지는 터치 스크린 디지털 인터페이스, 초음파 본더 헤드, 정렬 시스템, 매개변수 제어 장치, 본드 데이터 제어 장치 등 여러 가지 주요 구성 요소로 구성되어 있습니다. 디지털 인터페이스 (Digital Interface) 를 사용하면 프로세스 매개변수의 선택 및 표시와 함께 쉽고 직관적인 기계 제어를 수행할 수 있습니다. 초음파 본더 헤드 (Ultrasonic Bonder Head) 는 다양한 패키지 크기와 리드 길이를 처리 할 수있는 이중 축 시스템으로 구성됩니다. 정렬 시스템은 현미경, CCD 라인 스캔 카메라 및 번역 마이크로 미터 헤드로 구성됩니다. 이 구성 요소 조합은 인쇄 회로 기판 (printed circuit board) 과 칩 (chip's lead) 사이의 정렬을 측정하여 정확한 결합 배치를 보장할 수 있습니다. 매개변수 제어 장치는 주파수, 전력, 플럭스, 쐐기힘, 전극 블레이드 압력, 결합력 등 결합 프로세스의 다양한 특성을 제어하는 데 사용됩니다. 채권 데이터 제어 장치 (Bond Data Control Unit) 는 품질 보증 및 추적 용이성을 위해 채권 데이터를 저장하고 모니터링하는 데 사용됩니다. 3088 IP 장치는 자동화된 제조 공정을 위한 빠르고 편리한 결합 솔루션을 제공합니다. 이 기계는 처리율이 높으며 MCM (Multi-Chip Module), QFN (Quad Flat No-Lead Package), SOIC (Small Outline Integrated Circuit) 및 CSP (Chip Scale Package) 를 포함한 다양한 반도체 패키지를 처리 할 수 있습니다. 또한 자동 전원 및 온도 관리, 고급 플럭스 제어, 펄스 진동, 다중점 힘 제어 등의 고급 기능도 포함되어 있습니다. 기계 의 전반적 인 설계 는 결합 과정 중 에 "패키지 '나" 리드' 를 손상 시킬 위험성 을 크게 감소 시킨다. 또한, 시스템에서 생성하는 고품질 (High-Quality) 결과는 오류 없는 (Error-Free) 작업을 가능하게 하며, 가장 높은 정확도와 신뢰성으로 본드 (Bond) 작업을 수행할 수 있는 수준의 신뢰성을 제공합니다.
아직 리뷰가 없습니다