판매용 중고 STS / CPX Multiplex ICP #293603805
URL이 복사되었습니다!
확대하려면 누르십시오
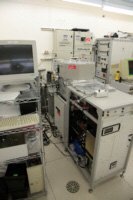



ID: 293603805
웨이퍼 크기: 6"
Deep Reactive Ion Etcher (DRIE), 6"
Type: Non-MESC
Anisotropic etch
Vacuum
Plasma
Materials: Silicon, SiNx
Gases: C4H8, SF6, O2
Photoresist masks
Etch rates: 1-2 µm/min
Mounted on 6" carrier wafer
Load lock
Manual.
STS/CPX Multiplex ICP (Inductive Coupled Plasma) 는 반도체 장치 제조 및 기타 응용 프로그램을위한 에처/애셔 장비입니다. 이 에처/애셔 시스템은 유도 결합 플라즈마 (Inductively Coupled Plasma) 또는 ICP를 사용하여 에칭 또는 애싱 (ashing) 을 위해 정확한 양의 반응성 가스를 웨이퍼에 전달합니다. ICP 소스는 다중 주파수 입력 전력을 사용하여 (일반적으로) 2 개의 전원 버스, 발전기 코일 및 척 전극을 통해 전자기장을 생성합니다. ICP 소스는 웨이퍼에서 재료를 배치 및 제거하기 위해 여러 프로세스를 사용합니다. 첫 번째 과정은 발전기 코일 (coil) 에서 고주파 AC 전력을 유도하여 척 (chuck) 에 전류를 유도하는 것입니다. 이 프로세스는 원하는 에치 (etch) 및 가스 증착 과정을 시작하는 웨이퍼에 국소화 된 온도 및 압력 그라디언트를 생성하기 위해 에칭/애싱 (etching/ashing) 에 중요합니다. 높은 전력 수준에서 ICP 소스는 두 번째 프로세스를 사용하여 Hall-effect 플라즈마를 생성합니다. 이 과정에서 ICP 소스는 AC 및 DC 전원 입력 조합을 사용하여 고밀도 전기 플라즈마를 만듭니다. 플라즈마 (Plasma) 는 DC 전력에 의해 생성 된 전위차에 의해 가속 된 전자에 의해 형성되며, AC 전력은 에치 (etch) 또는 애싱 (ashing) 과정에 대한 추가 수준의 제어를 제공한다. ICP는 반응성 가스 (에칭 또는 애싱) 와 필요에 따라 반응합니다. 프로세스의 ETCH/ASH 단계는 독립 소프트웨어에 의해 완전히 제어되므로, 다른 매개변수 중에서 이온화, 이온화 시간 및 총 에너지를 정확하게 제어 할 수 있습니다. 에치/애싱 (etch/ashing) 과정에서, ICP는 반응성 가스에 존재하는 화학 종과 상호 작용하여 플라즈마 필드를 만든다. 이 "플라즈마 '장 은" 웨이퍼' 에 도입 될 때, 원하는 과정 에 따라 "웨이퍼 '표면 의 재료 를 에치' 하거나 재 로 만드는 데 도움 이 된다. 반응은 스퍼터링 (sputtering) 과정과 유사하며, ICP는 스퍼터 소스의 역할을 담당한다. STS Multiplex ICP는 etch/ashing 외에도 화학 증기 증착 (CVD), 이온 이식, Micromask 증착 및 Thermal-Assisted Etching을 포함한 여러 프로세스에 적합합니다. 에처/애셔 장치는 실리콘, 저마늄 및 실리콘-온-인슐레이터를 포함한 여러 기질을 처리 할 수 있습니다. CPX Multiplex ICP는 디스플레이 생산에서 MEMS 장치 제조에 이르기까지 다양한 응용 프로그램에 사용됩니다. 기계의 유연성, 견고한 설계, 다수 에치/애싱 (etch/ashing) 프로세스에 적합한 선택
아직 리뷰가 없습니다

